半导体硅片作为芯片制造的核心基材,其表面和内部缺陷直接影响芯片良率与性能。传统人工检测受限于精度(仅能识别微米级缺陷)和效率(单次检测需数十分钟),已无法满足先进制程(如 3nm 以下工艺)对硅片质量的严苛要求。机器视觉检测技术凭借亚微米级精度(可达 0.1μm)、全表面 100% 覆盖检测和分钟级快速成像分析能力,成为半导体产业链中关键的质量管控手段。
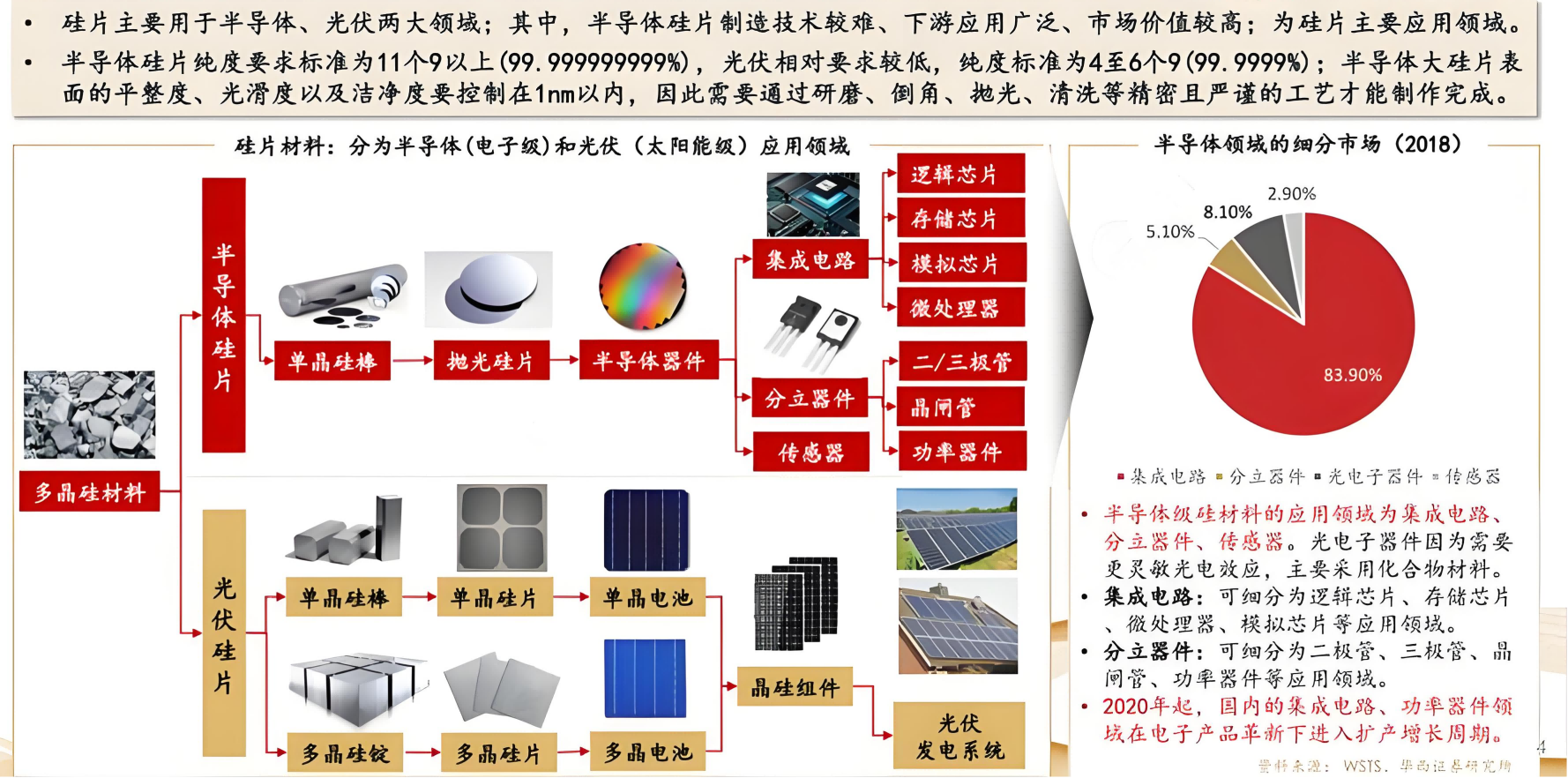
硅片缺陷按成因可分为原生缺陷(晶体生长阶段形成)和工艺缺陷(加工过程中产生),具体类型及检测要点如下:
1.微缺陷(Microdefects)
◦ 表现:直径 < 1μm 的原子级聚集缺陷(如 COP 空洞、OSF 氧化诱生层错),肉眼不可见,需通过激光散射或红外成像检测。
◦ 影响:导致器件漏电、击穿,尤其对 FinFET、GAA 等先进结构危害显著。
◦ 检测技术:暗场激光扫描显微镜(DF-LSM),利用缺陷对激光的散射信号成像,分辨率可达 0.2μm。

2.位错(Dislocations)
◦ 表现:晶体原子排列错位形成的线状或螺旋状缺陷,可能延伸至硅片表面。
◦ 影响:成为重金属杂质扩散通道,引发器件失效。
◦ 检测技术:化学腐蚀后光学显微镜观察(SEMI 标准 F47),或利用电子束缺陷检测(EBI)定位。

3.漩涡缺陷(Swirl Defects)
◦ 表现:硅锭生长时因温度梯度不均形成的漩涡状微缺陷群,直径约 10-100nm。
◦ 影响:降低载流子迁移率,影响芯片速度。
◦ 检测技术:需要通过高温氧化工艺使缺陷 “显影”,再用红外显微镜观察。
1.表面颗粒(Particles)
◦ 表现:直径 > 0.3μm 的尘埃、金属颗粒或硅碎屑,多来自切割、抛光环节。
◦ 影响:导致光刻图形失真、金属互连短路,是先进制程(<7nm)的主要良率杀手。
◦ 检测技术:激光扫描检测(LSC),通过颗粒对激光的反射光强变化识别,检测效率可达每片硅片 < 1 分钟。
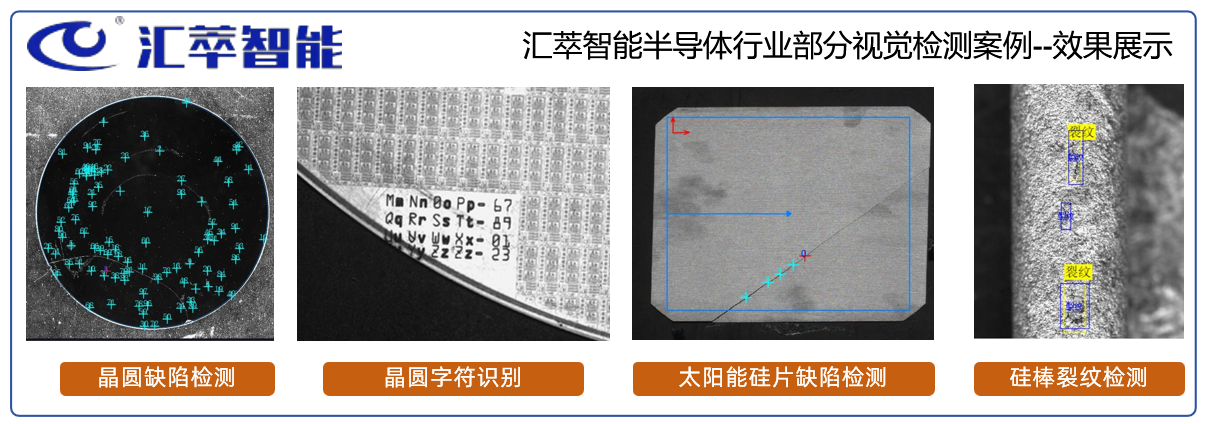
2.划痕(Scratches)
◦ 表现:机械加工(如研磨、清洗)导致的微米级线状损伤,深度可达数十纳米。
◦ 影响:成为应力集中点,可能引发硅片破裂或器件层间开裂。
◦ 检测技术:明场光学显微镜(放大 500-1000 倍)或原子力显微镜(AFM)精确测量深度。
3.氧化层缺陷(Oxide Defects)
◦ 表现:热氧化工艺中产生的针孔(Pinhole)、裂纹或厚度不均。
◦ 影响:栅氧化层缺陷直接导致 MOSFET 器件击穿,是存储芯片(如 DRAM)的致命缺陷。
◦ 检测技术:椭圆偏振光谱仪测量氧化层厚度均匀性,电容 - 电压(C-V)测试评估介质完整性。
半导体硅片视觉检测贯穿硅锭制备→切片加工→抛光清洗→外延生长→晶圆出货全流程,不同环节的检测重点与技术方案如下:

• 场景:硅锭截断后对端面进行检测,切片(厚度约 100-300μm)后对表面进行全检。
• 检测重点:微裂纹、晶体取向偏差、切割损伤层深度。
• 技术方案:
◦ 激光扫描断层成像(Laser Tomography):检测硅锭内部微裂纹,分辨率达 50μm。
◦ 红外透射显微镜(IR-TOM):穿透硅片(硅对 1100-1800nm 光透明)检测内部颗粒与位错。
• 场景:硅片抛光后(表面粗糙度 < 1nm)进行出货前全检,是半导体厂商接收硅片的关键质控点。
• 检测重点:表面颗粒、划痕、平整度(TTV<1μm)、微粗糙度(Ra<0.5nm)。
• 技术方案:
◦ 全自动光学检测机(AOI):结合暗场与明场成像,实现颗粒检测(0.3μm)与表面形貌分析。
◦ 白光干涉仪(WLI):测量表面粗糙度与台阶高度,精度达亚纳米级。
• 场景:在硅片表面生长外延层(如 SiGe、SOI)后,检测层间界面缺陷与外延层质量。
• 检测重点:外延层厚度均匀性、层错密度、应力引起的裂纹。
• 技术方案:
◦ 光致发光光谱(PL):通过激发光检测外延层晶体质量,快速识别非辐射复合中心。
◦ 扫描电子显微镜(SEM):观察外延层表面形貌,结合能谱分析(EDS)确认元素分布。
1.纳米级缺陷检测:随着制程向 3nm 以下演进,需检测尺寸接近电子束波长的缺陷,传统光学检测接近物理极限。
2.多物理场融合:单一检测技术难以覆盖所有缺陷类型,需融合光学、电子束、X 射线等多模态数据。
3.实时性要求:先进制程硅片单价超万美元 / 片,需在 10 分钟内完成全片检测并定位缺陷,对算法算力提出极高要求。
1.电子束检测(EBI)普及:利用电子束波长优势(<0.1nm),实现原子级缺陷成像,如 Thermo Fisher 的 Helios G4 PFIB 系统。
2.AI 驱动的智能检测:通过深度学习算法(如卷积神经网络 CNN)自动识别罕见缺陷,降低对人工标注的依赖。
3.原位检测技术:在沉积、刻蚀等工艺设备中集成在线检测模块,实现缺陷 “边制造边检测”,缩短良率反馈周期。

半导体硅片视觉检测是保障芯片制造 “地基” 质量的核心技术,其发展直接映射着摩尔定律的演进节奏。从微米到纳米,从单一光学检测到多技术融合,这一领域正通过持续的技术创新,为全球半导体产业的高质量发展筑牢根基。未来,随着先进制程与新材料的应用,视觉检测技术将不断突破物理极限,成为半导体产业链中不可或缺的 “质量守门人”。

返回顶部

汇萃智能半导体视觉检测解决方案以全栈自主研发技术为核心竞争力:凭借丰富的机器视觉与AI算法库及HCAI深度学习模型,适配工艺迭代需求;融合多模态成像技术突破材质检测瓶颈,搭配工业级高稳定硬件配置,适配洁净车间环境并支持7×24小时连续运行;兼容主流工业协议,可与产线系统无缝联动实现全流程自动化。方案通过核心环节全覆盖检测实现行业领先的缺陷检出率,显著提升芯片良率,单套设备可替代多名人工,大幅提升检测速度、降低综合成本,满足行业合规要求。

在半导体制造向微米级、纳米级工艺演进的过程中,芯片隐裂已成为制约良率的 “隐形杀手”。这类裂纹多产生于晶圆切割、封装应力、运输震动等环节,肉眼不可见且深度埋藏于芯片内部或封装层下,传统可见光检测因穿透性不足难以识别,X射线检测则存在成本高、效率低、辐射风险等局限,给半导体企业带来批量不良、下游召回等潜在损失。汇萃智能依托十余年机器视觉技术积淀,基于短波红外技术提供配套的视觉检测方案,以“穿透式成像+AI智能识别”的核心优势,精准破解芯片隐裂检测难题,为半导体制造筑牢品质防线。

3月2日,以“忠诚担当谱新篇,实干争先开新局”为主题的浙江第一经济大区余杭区经济高质量发展大会隆重召开。大会锚定打造人工智能创新发展第一城核心承载地的目标,重磅发布系列行动、集中亮相未来项目,为区域经济高质量发展擘画新路径。

1月28日,浙江省首批 “科技新小龙” 发布大会在杭州隆重召开,汇萃智能受邀出席并正式获授 “科技新小龙” 荣誉牌匾!此次从全省超 10 万家科技型中小企业中脱颖而出,跻身首批 96 家入选企业行列,既是官方对公司技术创新实力与高成长潜力的高度认可,更是一份沉甸甸的责任与期许。